主要実験装置EQUIPMENTS
.jpg)
分子線エピタキシー(MBE)装置
・到達真空度:10-9 Torr以下
・マニピュレータ温度:〜1000℃
・3連チャンバー+搬送チャンバー(中央)
Si, Ge基板の上にFe3Si, Co2FeSi等の高品質ホイスラー合金を作製します。

分子線エピタキシー(MBE)装置
・到達真空度:10-8 Pa以下
・マニピュレータ温度:〜1000℃
Si, Ge基板の上にGeやSn等を蒸着します。

原子層堆積(ALD)装置
・到達真空度:〜10-5 Pa
高品質なAl2O3やHfO3などの絶縁膜を作製します。
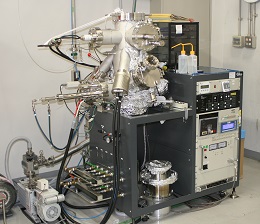
電子線蒸着装置
・到達真空度:〜10-5 Pa
・蒸着元素:Au, Ti, Ge, Co, Cu, Pt等
電極に用いるAu, Ti等の金属を蒸着します。
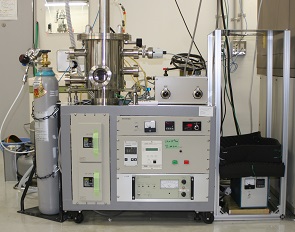
RFスパッタ装置
・到達真空度:10-7 Torr
・スパッタ電源:RF
SiO2, Si3N4等の絶縁膜を堆積します。

抵抗加熱蒸着装置
・到達真空度:10-5 Pa
Cu等の金属を堆積します。
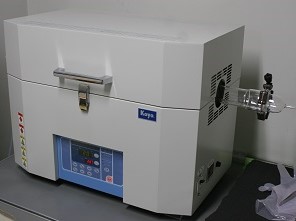
電気炉
長時間の加熱処理に使用します。
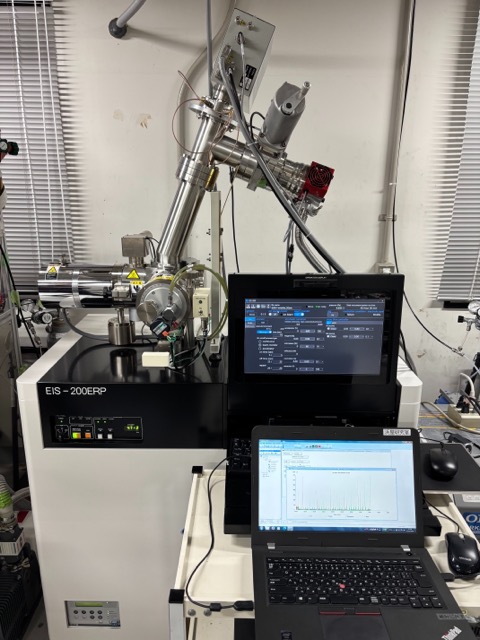
ドライエッチング装置、二次イオン質量分析計1
・イオン化ガス:Ar, O2
・加速電圧:100〜3000 V
金属、半導体、絶縁膜の薄膜をエッチングします。
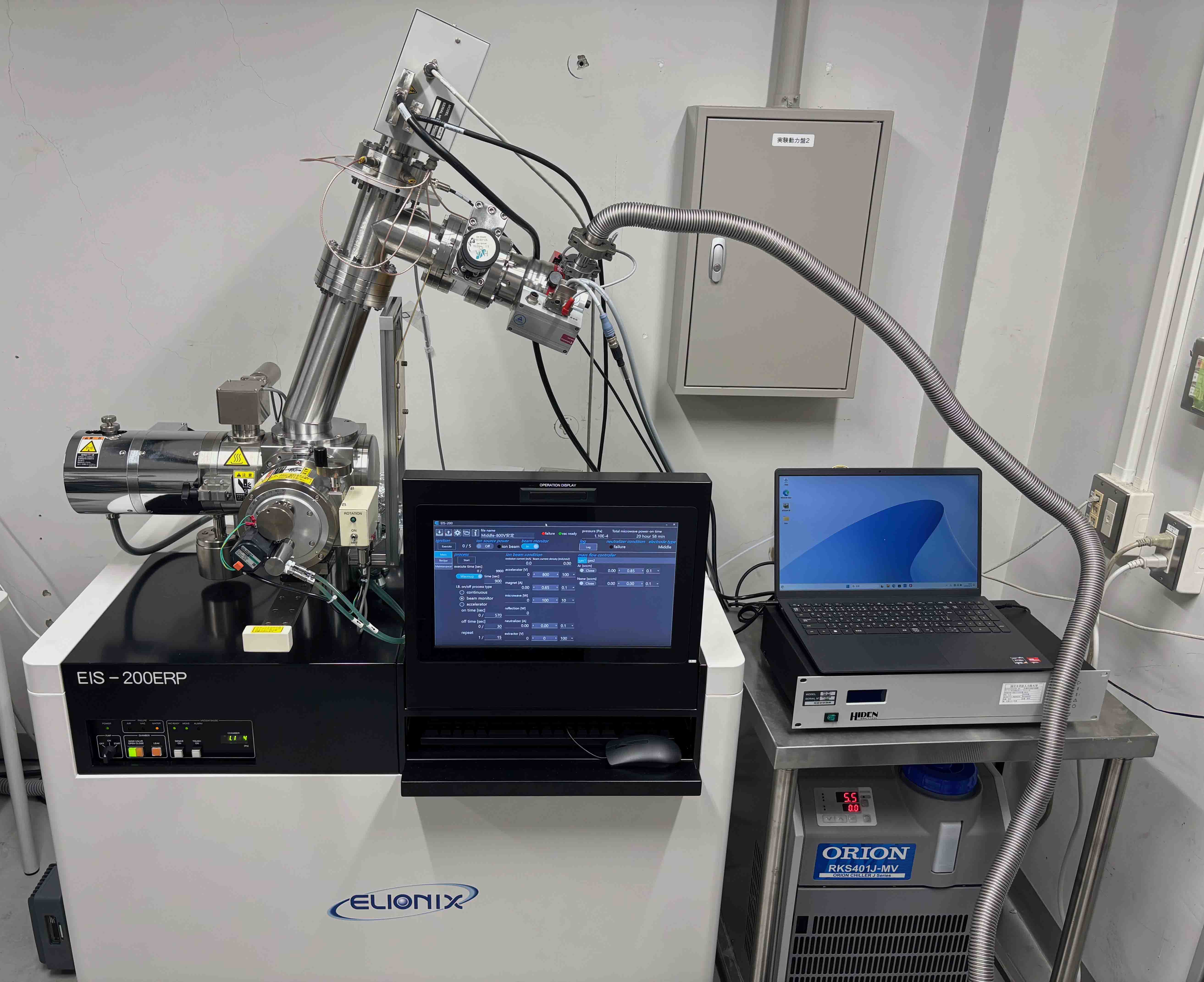
ドライエッチング装置、二次イオン質量分析計2
(・ドライエッチング装置 : 大阪大学 先導的学際研究機構 スピン学際研究部門 所有)
(・二次イオン質量分析計 : 浜屋研究室 所有)
・イオン化ガス:Ar
・加速電圧:100〜3000 V
金属、半導体、絶縁膜の薄膜をエッチングします。
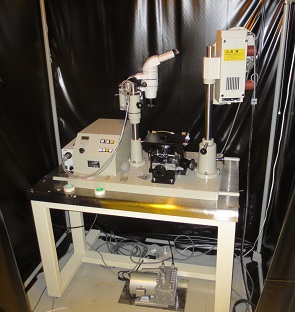
フォトリソグラフィー装置
素子のパターニングをします。
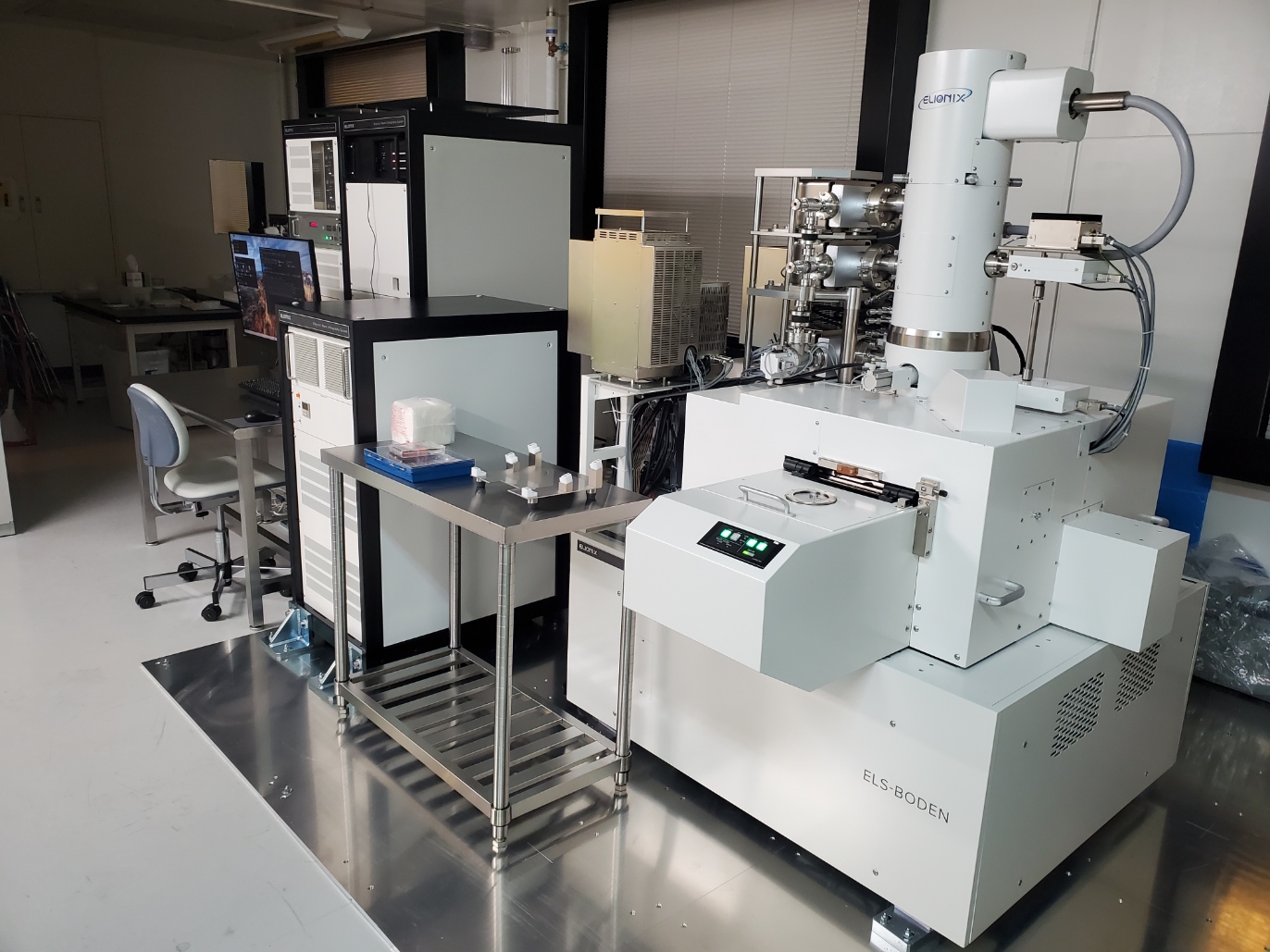
電子線描画装置
(大阪大学 先導的学際研究機構 スピン学際研究部門 所有)
素子のパターニングをします。

スクライバー
試料を切断するのに使用します。

微分干渉顕微鏡
試料の表面や作製した素子を観察するのに使用します。

ワイヤーボンダー
AuやAlワイヤーで素子を配線するのに使用します。

物理特性測定システム(PPMS)
・測定温度:1.9〜400 K
・最大印加磁場:9 T
作製した試料の磁気特性や磁気抵抗などを測定する装置です。
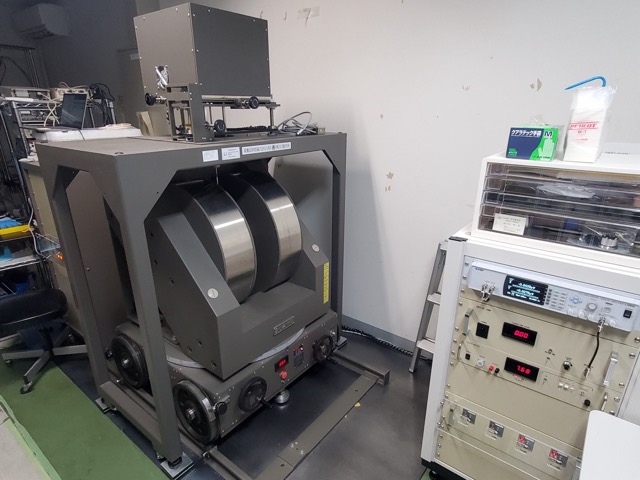
振動試料型磁力計(VSM)
・測定温度:室温
・最大印加磁場:1.57 T
作製した試料の磁気特性を測定する装置です。
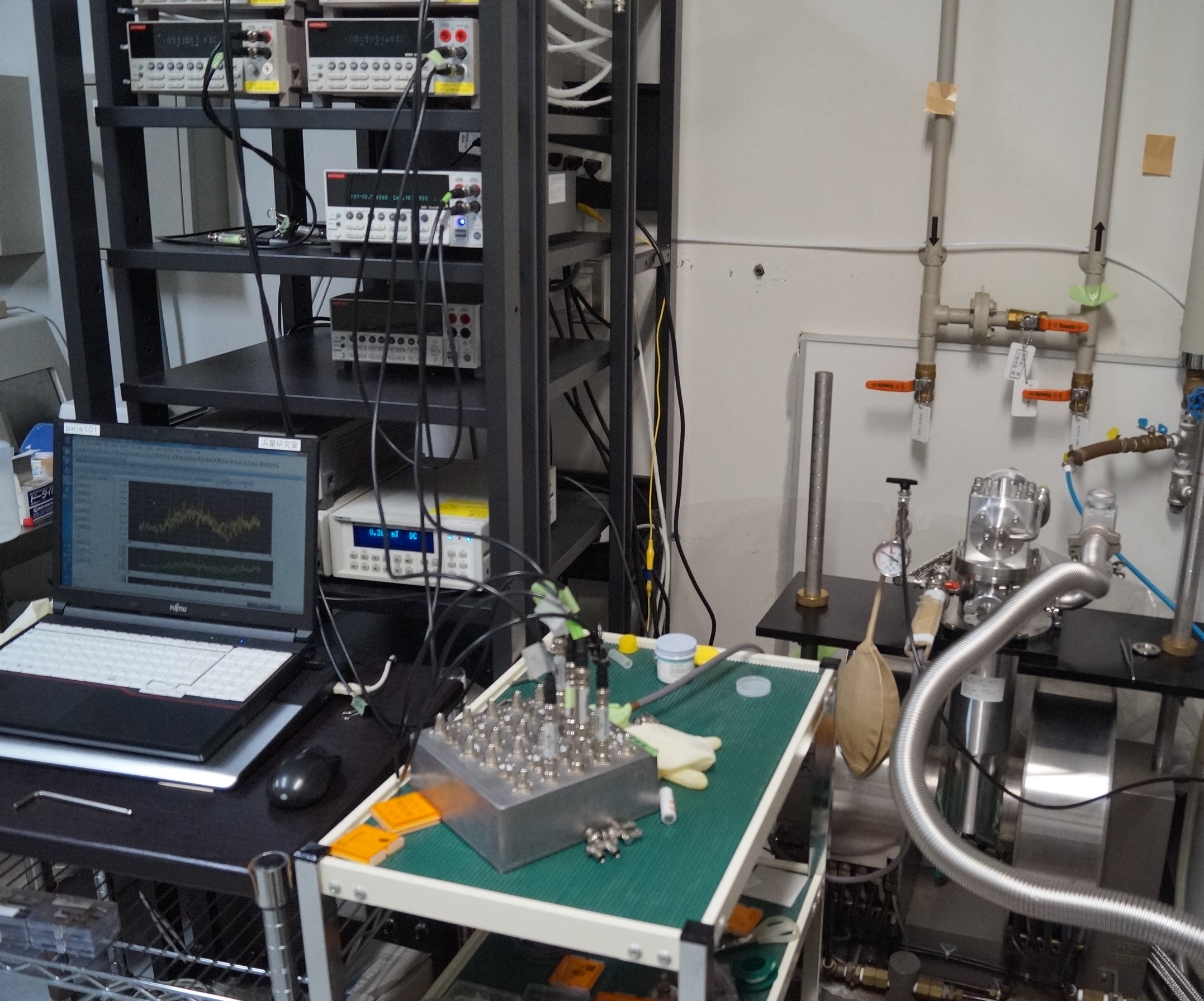
磁気抵抗効果測定装置1
・測定温度:3〜320 K
・最大印加磁場:0.6 T
作製したスピン注入・検出素子を測定する装置です。
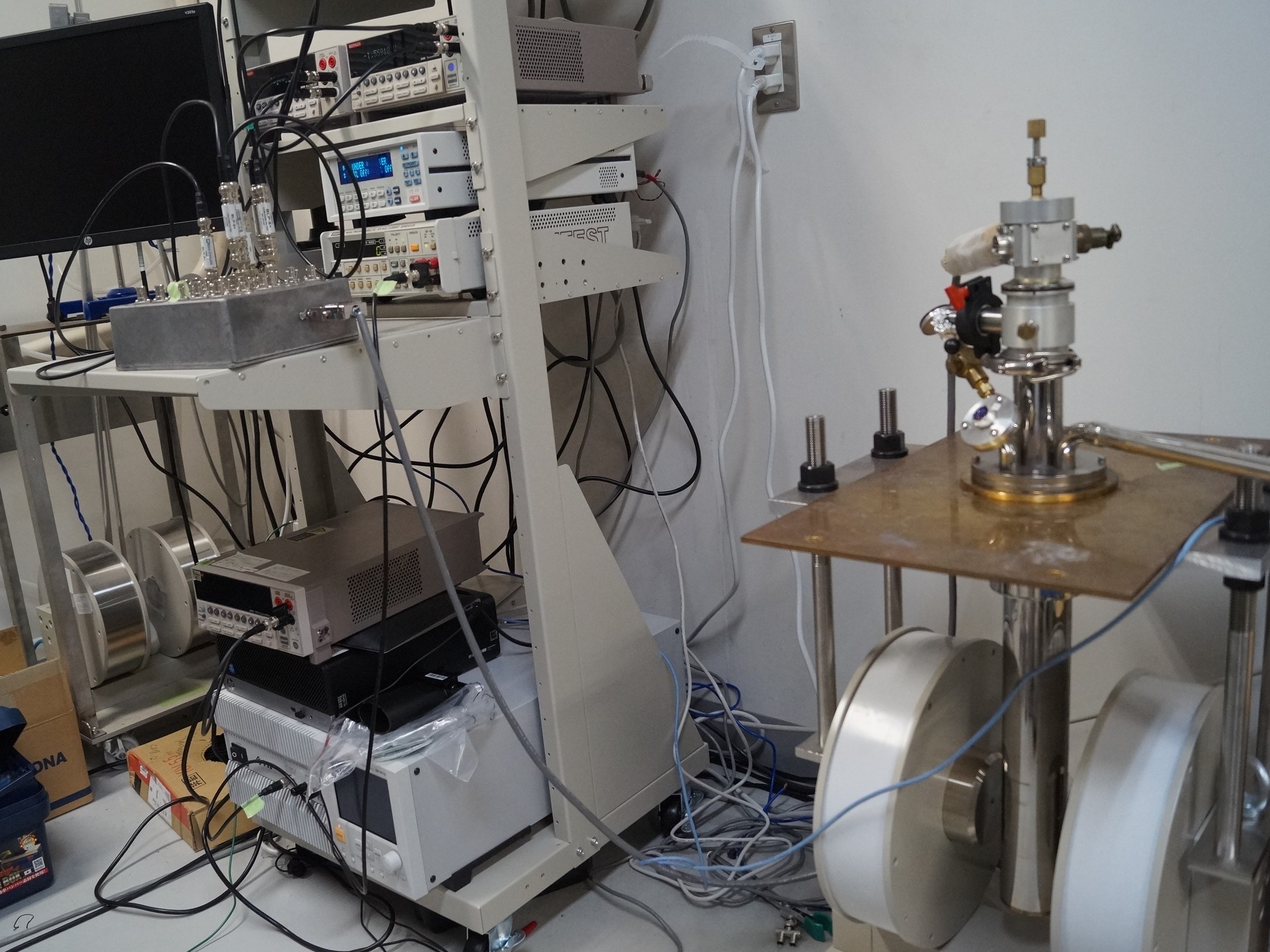
磁気抵抗効果測定装置2
・測定温度:室温
・最大印加磁場:0.6 T
作製したスピン注入・検出素子を測定する装置です。

磁気抵抗効果測定装置3
・測定温度:3〜320 K
・最大印加磁場:〜1 T
作製したスピン注入・検出素子を測定する装置です。

磁気抵抗効果測定装置4
・測定温度:3〜320 K
・最大印加磁場:0.6 T
作製したスピン注入・検出素子を測定する装置です。
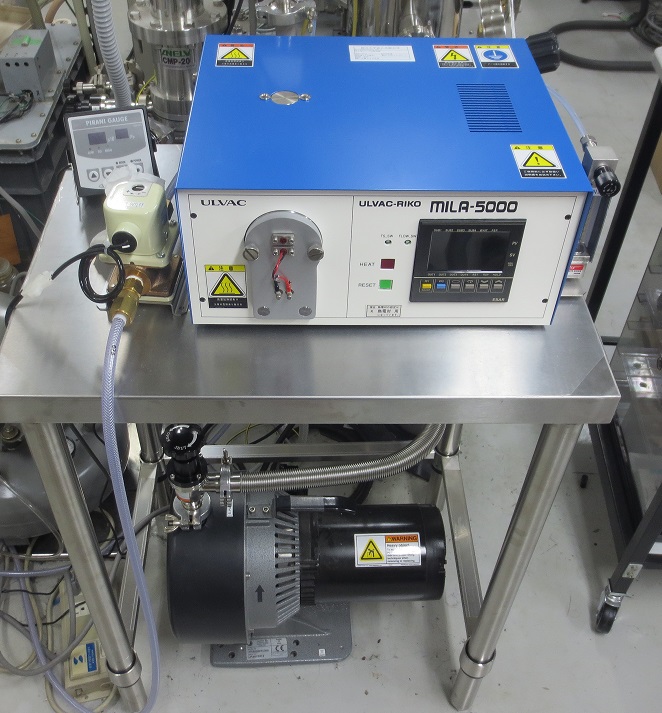
高速熱処理(RTA)装置
試料を急速加熱する装置です。
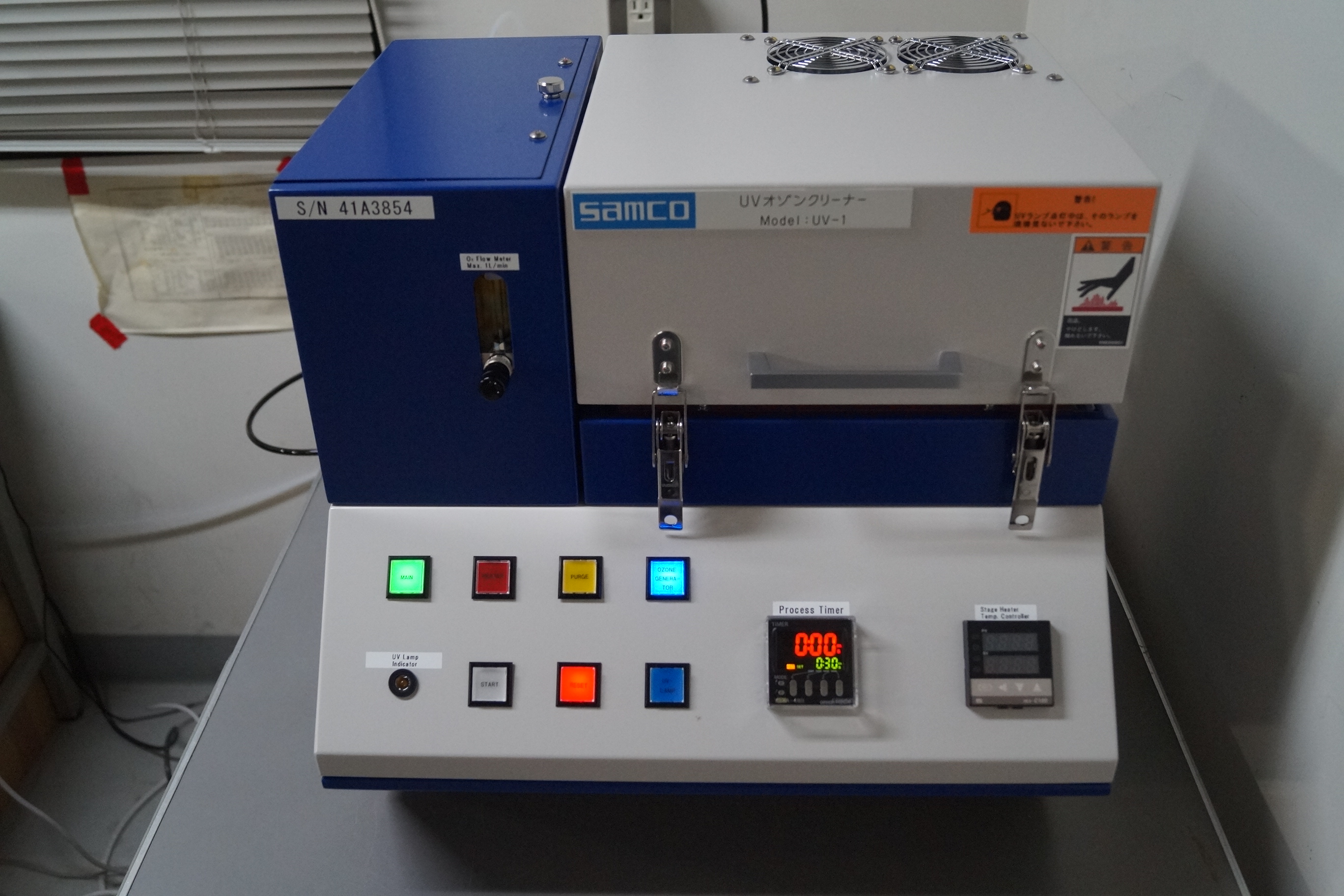
UVオゾン洗浄装置
・プロセス温度:室温~300℃
紫外線と高濃度オゾンを用いて各種有機物の除去を行う装置です.

半導体デバイス・パラメータ・アナライザ
半導体素子のI-V特性などを測定する装置です。

電子顕微鏡(SEM)
微細な素子を観察する卓上サイズの装置です。

Kerr効果顕微鏡
磁区構造を観察する装置です。